
La salle blanche s'étend sur une surface de 750m². De classe 1000 à 100, elle est dédiée à la formation et à la recherche.
Elle est composée de modules technologiques permettant la réalisation des étapes élémentaires d'élaboration de circuits et microsystèmes intégrés ainsi que les contrôles physiques et électriques pour le suivi des procédés :
Wetbench (Nettoyage, gravure humide), oxydation, dopage par diffusion, traitement thermique, photolithographie, gravures chimiques, implantation, gravures par faisceau d'ions IBE, ionique réactives ICP-RIE, profonde (DRIE), dépôts ALD, PECVD, LPCVD, PVD, gravure humides, contrôles

TTH oxydation et recuit d’activation
Il s’agit d’un ensemble de 3 tubes:
- équipé de lignes de gaz O2 et N2 pour réaliser des oxydations sèches, et également d’une ligne de H2 et d’une torche pour réaliser des oxydations humides; il fonctionne entre 800 et 1100°C.
- équipé d’une ligne de N2 (et aussi d’O2) pour réaliser des recuits (oxydants) jusqu’à 900°C.
- tube LYDOP® qui permet de faire du dopage par diffusion phosphore, à l’aide d’une solution liquide de POCl3, d’O2 et de N2.
Compatibles 2 et 4 pouces

Dopage
Le tube LYDOP® permet de faire du dopage par diffusion phosphore, à l’aide d’une solution liquide de POCl3, d’O2 et de N2.
L’implanteur ionique moyen courant IMC 200 revB de la société IBS est utilisé pour le dopage des semiconducteurs durant la fabrication des dispositifs (sur des plaquettes silicium de 2 et 4 pouces).
Les atomes dopants sont le bore (B), le phosphore (P) et l’arsenic (As).
La source gazeuse est de type Freeman à plasma (gaz BF3, arsine AsH3 et phosphine PH3) avec extraction à 20 kV.
Le dopage s’effectue à des énergies de 50 à 200 keV (kilo électron-Volt).
Compatibles 2 et 4 pouces


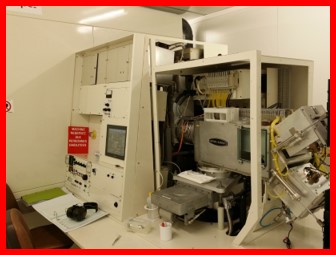
Recuit rapide et MEMS DRYER
Le RTA JIPELEC JETFIRST® permet de faire des recuits rapides de 300 à 1000°C avec des rampes très courtes .
Le sécheur super critique MEMS dryer permet de sécher des structures types polymères
Compatibles 2 et 4 pouces

Dépôts CVD, PECVD et LPCVD
L’équipement PECVD permet de déposer des couches minces de matériaux par la technique de dépôt chimique en phase vapeur, assisté par plasma.
Les gaz utilisés sont: le silane (SiH4), le protoxyde d’azote (N2O), l’ammoniac (NH3), et le diazote (N2).
L’équipement LPCVD permettent de réaliser des couches minces de matériaux par la technique de dépôt chimique en phase vapeur à faible pression: dépôts de silicium polycristallin (ou polysilicium), dopé in situ phosphore, et des nitrures de silicium stœchiométrique ou de faible contrainte.
Compatibles 2 et 4 pouces

Dépôts ALD
Les équipements ALD permettent de déposer des films uniformes, d’épaisseur contrôlée à l’échelle atomique, en utilisant des réactifs gazeux appelés « précurseurs », introduits de façon séquentielle. Le dépôt est basé sur des réactions gaz-solide saturées, séparées et auto-limitantes. Les dépôts sont réalisés selon des procédés thermiques, et peuvent aussi être assistés par plasma (PEALD).
L’équipement FLEXALOxford se compose d’une source plasma ICP remote, de 6 lignes de gaz (Ar, N2, H2, NH3, O2, CF4), et d’un cabinet de 6 précurseurs chimiques: Ta, Gd, Ru, Al, Ti, Hf.
Compatibilité: de l’échantillon au wafer diamètre 200mm

Dépôts PVD
L’équipement CT100 Alliance Concept permet le dépôt en couches minces de nombreux matériaux grâce au procédé PVD (dépôt physique en phase vapeur) avec une vitesse élevée (jusqu’à 300 nm/min).
L’équipement est composé de 2 chambres sous vide reliées par un SAS sous vide de chargement :
- la chambre « métaux » équipée de 4 cibles de pulvérisation avec magnétron Al, Ti, Ta et Nb, et un générateur DC,
- la chambre « magnétiques » équipée de 4 cibles magnétron SiO2, Si3N4, NiFe et ITO, 2 générateurs RF et un générateur DC pulsé.

Photolithographie
L’équipement MA8-BA8 permet d’exposer des substrats de 2 à 8 pouces de diamètre. L’alignement peut se faire à la fois en face avant et en face arrière (TSA / BSA).
Cet équipement dispose également de 2 autres modules:
- Le mode SCIL (Substrate Conformal Imprint Lithography), nouvelle technologie de nano-impression qui permet de réaliser des motifs jusqu’à 50 nm (ils sont imprimés dans le substrat avec un tampon combinant la rigidité du verre et la flexibilité du polymère PDMS).
- Le mode SELECT (Selective Plasma Activation), technique développée par Süss Microtec qui permet de modifier les propriétés d’une surface de façon localisée à l’aide d’un masque et d’un plasma (hydrophile, hydrophobe, oxydation, réduction, dépôt).
2 autres équipements de photolithographie complètent le parc :
compatibles 2 à 4 pouces, litho TSA et BSA

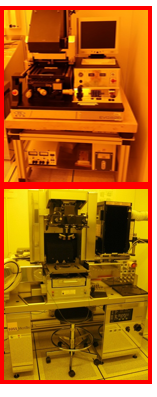
Bondeur, nanoinprint et photolithographie
Bonder Suss Microtec (4 pouces)
Suss Microtec MJB4 et MA150
compatibles 2 à 6 pouces, litho TSA et BSA
Wetbench associé pour étalement de résine, développement après exposition, et lift-off

Gravure
L’équipement SPX HRM 180 du fabriquant SPTS est un bâti de gravure profonde du silicium pour microsystèmes.
De la famille des «gravures ioniques réactives » ou RIE (Reactive ion Etching), il utilise un plasma type ICP (Inductively Coupled Plasma).
Nanoplas DSB9000: conçue pour graver les polymères et résines épaisses à grande vitesse, utilisant une source de radicaux à forte densité.
Compatibilité 2 à 4 pouces

L’ICP RIE Corial est un équipement de gravure réactive ionique équipé d’une source plasma inductive avec un réacteur à parois chaudes pour réduire la condensation de polymères et permettre les nettoyage assistés par plasma.
Les plasmas produits, de forte densité, permettent de travailler dans une large gamme de pression (1 to 50 mTorr) avec des vitesses de gravure rapides, pour des plaques (wafers) jusqu’à des diamètres de 200mm.
L’équipement IBE est « un usineur ionique » qui permet de graver de nombreux matériaux. Il est composé d’une source d’ion, d’un système de 3 grilles pour mettre en forme le faisceau. Il dispose également d’un neutraliseur. Le porte substrat accueille des échantillons jusqu’à 150 mm de diamètre et maximum 6 mm d’épaisseur.


Le bâti de gravure HF est conçu pour réaliser la gravure sèche d’oxyde de silicium (SiO2). Il utilise la libération par voie sèche (dry release of microstructures), évitant la déformation ou le collage de la microstructure libérée ou suspendue.
La machine de CMP (Chemical Mechanical Polishing) est conçue pour polir et planariser des couches d’oxydes ou de métaux sur des wafers de 2 et 4 pouces et des échantillons de 10*10mm2.


Chimie - Sorbonnes
Les sorbonnes, sous extraction contrôlée, permettent de réaliser les étapes de nettoyage et de gravure en toute sécurité pour l’opérateur.

Caractérisations - contrôles
La salle blanche est équipé:
- d’un MEB ZEISS (compatibilité de l’échantillon au 4 pouces) ,
- d’un profilomètre (2 et 4 pouces) ,
- d’un ellispsomètre (jusqu’à 200mm)





